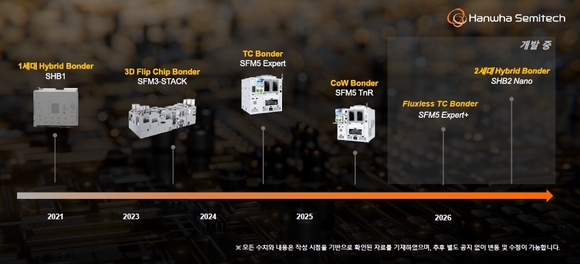
▲한화세미텍 첨단 반도체 패키징 장비 개발 로드맵 / 사진=한화세미텍
한화세미텍은 내년 초 하이브리드본더를 출시하며 차세대 첨단 패키징 장비 시장 주도권 확보에 나선다. 하이브리드본더는 미래 반도체 시장을 이끌 핵심 장비로 반도체의 성능과 생산효율을 크게 높여 향후 반도체 산업의 ‘게임 체인저’가 될 전망이다.
한화세미텍은 대만 타이페이에서 열린 국제 반도체 박람회 ‘세미콘타이완 2025’에서 하이브리드본더 청사진을 담은 차세대 첨단 반도체 패키징 장비 개발 로드맵을 발표했다고 10일 밝혔다.
개발 로드맵에 따르면 2024년 TC본더 ‘SFM5 Expert’, 2025년 CoW(Chip-on-Wafer) 멀티칩본더 ‘SFM5 TnR’ 출시에 이어 2026년 초 플럭스리스본더 ‘SFM5 Expert+’, 하이브리본더 ‘SHB2 Nano’를 출시할 계획이다.
반도체 장비 시장에서 가장 큰 관심을 받고 있는 하이브리드본더는 고대역폭 메모리(HBM) 성능과 생산 효율을 크게 향상시킬 것으로 기대된다.
현재 HBM제조에 주로 사용되는 TC본더는 범프(납과 같은 전도성 돌기)에 열과 압력을 가해 칩과 칩을 붙인다.
이와 달리 하이브리드본더는 별도의 범프 없이 칩을 붙일 수 있어 20단 이상의 고적층칩 제조에 필수적인 장비로 평가받고 있다. 칩 사이 범프가 없기 때문에 전기신호 손실을 최소화할 수 있어 반도체 성능도 크게 향상된다.
글로벌시장조사업체 테크인사이츠에 따르면, 후공정 하이브리드본더 시장 규모는 2033년 16억 달러(약 2조2201억 원)까지 커질 전망이다.
한화세미텍은 '세미콘타이완 2025'에서 멀티칩본더, 플럭스리스본더, 하이브리드본더 등 주요 차세대 장비를 선보인다. 이 중 SFM5 TnR을 포함한 일부 장비는 현장에서 직접 구동 시연을 할 예정이다.
한화세미텍 첨단 패키징 장비의 특징은 뛰어난 품질관리 능력과 고도의 정확성이다. 특히, 하이브리드본더의 경우 금속과 비금속 본딩 과정에서 틈(Void)가 생기지 않게 하는 게 무엇보다 중요하다.
곧 선보일 2세대 하이브리드본더 장비는 본딩시 위치 오차범위 0.1μm(마이크로미터) 단위의 수준으로 정밀 정렬이 가능하다. 이는 머리카락 굵기(약 100μm)의 1/1000 정도의 초정밀 본딩 기술 덕분이다.
박영민 한화세미텍 반도체장비사업부 사업부장은 “한화세미텍은 앞서 2022년 하이브리드본더 1세대 장비를 고객사에 성공적으로 납품했다”며 “현재 개발 중인 2세대 장비는 내년 1분기 고객사 평가를 받을 수 있도록 준비 중”이라고 말했다.
플럭스리스본더와 하이브리드본더 등 차세대 장비 출시로 한화세미텍은 글로벌 종합 반도체 기업(IDM)과 패키징 기업(OSAT)의 요구사항을 유연하게 대응할 수 있는 전방위 반도체 장비 라인업을 갖출 예정이다.
박혜연 기자 phy@datanews.co.kr
[ⓒ데이터저널리즘의 중심 데이터뉴스 - 무단전재 & 재배포 금지]
최신뉴스
많이 본 뉴스









